中国振华集团永光电子有限公司
摘要:具有宽带隙、高电子饱和速度和高击穿电压等良好特性的氮化镓(GaN)材料作为第三代半导体材料——宽禁带半导体材料之一,推动微电子领域和光电子学领域向前迈出了极为重要和有重大意义的一步,而以GaN材料制造的功率半导体器件AlGaN/GaN HEMT器件对半导体器件领域的发展也有着极其重大的影响。本文概述了GaN材料的基本特性以及AlGaN/GaN HEMT 器件的工作原理。
氮化镓(GaN)作为第三代半导体材料——宽禁带半导体材料之一,具有许多良好的特性,使得氮化镓材料成为推动光电子、高温大功率器件和高频微波器件不断向前发展的重要材料。GaN材料使得光电子学方向有了许多突破性进展。如:蓝光LED、CW蓝光激光器、GaN紫外探测器等。GaN材料的优势主要有以下几个方面:
禁带宽度比较大
GaN的禁带宽度高达3.4eV,大约是第一代半导体材料Si的3倍,第二代半导体材料GaAs的2.4倍;抗辐照能力也远远大于Si和GaAs。所以GaN基宽禁带半导体器件对于推动空间科学和技术领域的发展有着极其重要的作用。又因为 GaN材料本征载流子浓度很低,在一定的温度范围内,能够较为精准的控制自由载流子的浓度,所以GaN基宽禁带半导体器件在高温条件下仍然具有稳定性。
(2)相对介电常数较低
GaN材料的相对介电常数是9.8,比之第一代半导体材料Si低了1.6,更是第二代半导体材料GaAs低了3.3左右。电容C与介电常数ε的关系:C=εS/4πkd,电容与介电常数成正比;所以在掺杂浓度和外加电压相同的情况下,GaN材料构成的PN结电容比Si和GaAs都小,更适用于高频。
临界击穿电场强度较高
GaN材料的临界击穿电场强度为5*106V/cm,大约是GaAs和Si的8倍左右;所以GaN基半导体器件能够在高电压下正常工作。又在同样的耐压额定值下,GaN基器件的导通电阻相对比较小,因此,可以承受更大的电流通过。
载流子饱和漂移速度高
要想获得较大的电流密度,就需要器件在高电场强度下工作使仍然能够保持较高的迁移率,具有高电子饱和迁移速度(2.5*107cm/s)的GaN基器件刚好满足这一点,因此,在功率密度不变的条件下,GaN材料可以使得频率特性得到改善。
除此之外,GaN材料作为直接带隙半导体材料,它的光跃迁几率要比间接带隙半导体要高出一个数量级。所以发光效率非常高,是制作发光器件的极佳材料。
GaN材料本身的热导率只有1.3W/cmK左右,而SiC的热导率是GaN的3.7倍多。GaN和SiC间存在较小的晶格失配,在SiC衬底上可以通过生长一层高质量的GaN异质外延,GaN器件正是利用了SiC的高热导率特性;器件的耐高温程度取决于热导率的大小,因此,GaN器件在高温下仍有较好的特性。
近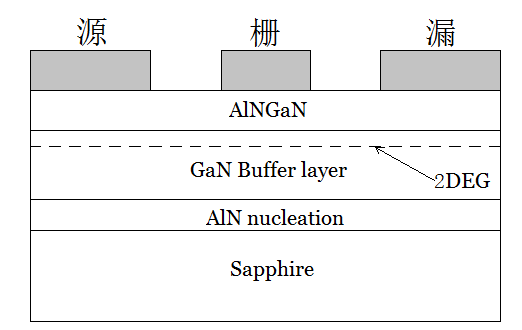 些年以来,半导体器件的使用条件越来越偏向于高频、大功率、耐高温以及抗辐照等等;而输出功率低,工作频率有局限的第一代和第二代功率半导体器件已经不能够满足条件。而GaN材料的良好特性使得AlGaN/GaN HEMT器件具有良好高频、耐高温特性,因此也得到迅速的发展。AlGaN/GaN HEMT器件作为场效应晶体管的一种,AlGaN/GaN HEMT器件的基本结构剖面如图1所示。它的基本工作原理如下:
些年以来,半导体器件的使用条件越来越偏向于高频、大功率、耐高温以及抗辐照等等;而输出功率低,工作频率有局限的第一代和第二代功率半导体器件已经不能够满足条件。而GaN材料的良好特性使得AlGaN/GaN HEMT器件具有良好高频、耐高温特性,因此也得到迅速的发展。AlGaN/GaN HEMT器件作为场效应晶体管的一种,AlGaN/GaN HEMT器件的基本结构剖面如图1所示。它的基本工作原理如下:
图1 AlGaN/GaN HEMT器件的典型结构剖面图
对源漏端施加电压,这时流过器件的电流可以通过栅端的电压来控制,其特性就类似于开关。详细来说就是施加正向偏压在漏端,然后在沟道中积累的二维电子气(2DEG)会在源漏之间的压降下形成电流,而该电流的大小是由栅端所施加的电压VG控制。通过向负值方向增加栅压VG会使得二维电子气在栅区下面耗尽,直到沟道夹断,电流达到饱和。AlGaN/GaN HEMT中最核心的部分就是AlGaN/GaN异质结构和在其界面处形成的二维电子气。我们知道AlGaN/GaN HEMT器件在微波领域有着极其重要的应用,而这一点要归功于AlGaN/GaN异质结构中二维电子气的存在。
在异质结中,费米能级EF是连续的,所以两个能带会发生不同程度的弯曲。在AlGaN/GaN异质结的界面处形成非常窄的势阱,使得电子在势阱中只能在平面内移动,这些电子就被称为二维电子气(Two Dimensional Electron Gas,2DEG)。它是许多场效应器件(如MOSFET、HEMT)工作的基础。AlGaN/GaN异质结构中,二维电子气主要来源于极化效应,与第二代的AlGaAs异质结构不同的是AlGaAs HEMT的二维电子气主要来源于n+掺杂的AlGaAs层。
[1] 常远程,AlGaN/GaN高电子迁移率晶体管的模型研究,西安电子科技大学博士论文,2006
[2] 杨丽媛,氮化镓基HEMT器件高场退化效应与热学问题研究,西安电子科技大学博士论文,2013